 EUV 曝光技术.docx
EUV 曝光技术.docx
- 文档编号:11164590
- 上传时间:2023-02-25
- 格式:DOCX
- 页数:7
- 大小:145.10KB
EUV 曝光技术.docx
《EUV 曝光技术.docx》由会员分享,可在线阅读,更多相关《EUV 曝光技术.docx(7页珍藏版)》请在冰豆网上搜索。
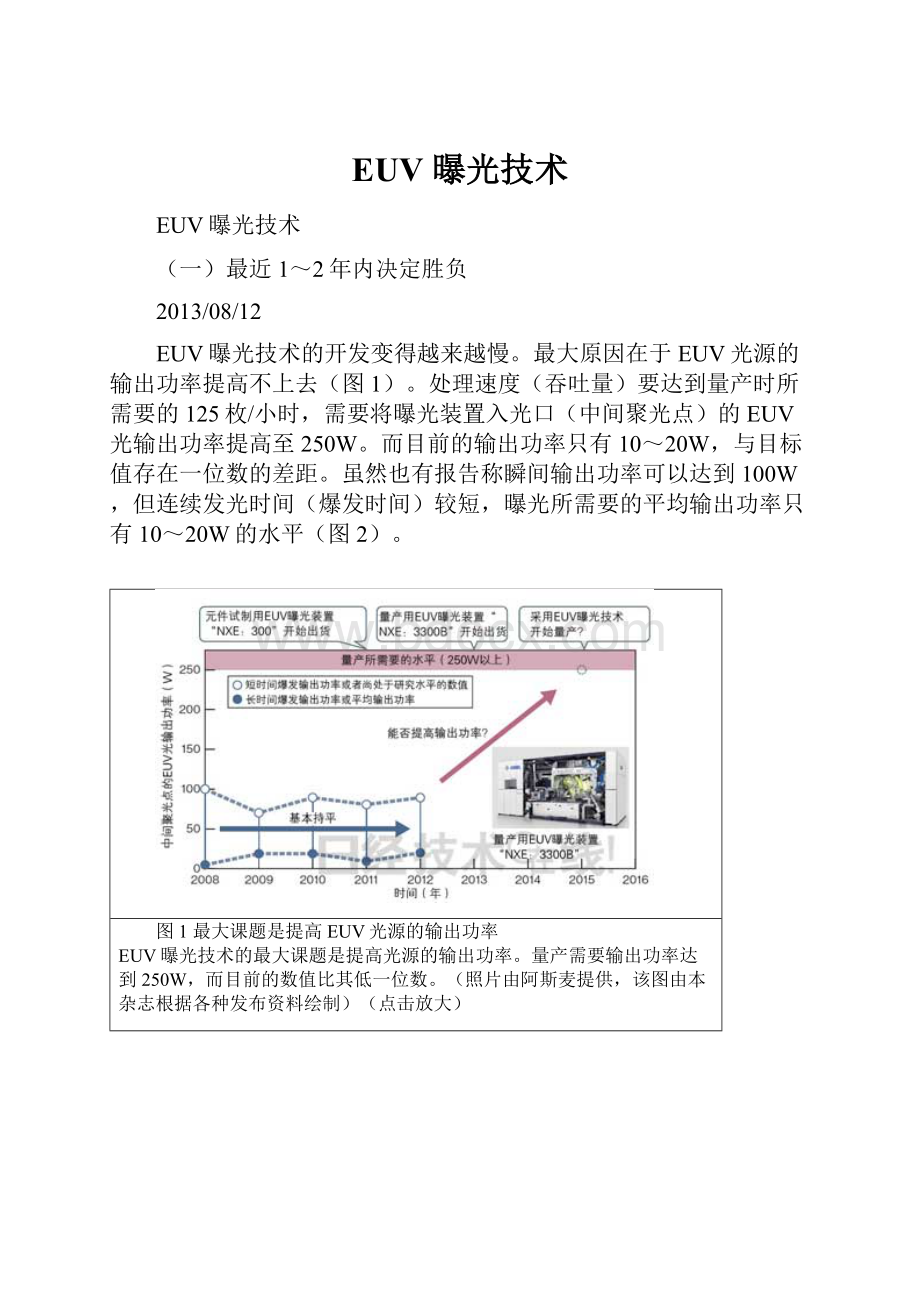
EUV曝光技术
EUV曝光技术
(一)最近1~2年内决定胜负
2013/08/12
EUV曝光技术的开发变得越来越慢。
最大原因在于EUV光源的输出功率提高不上去(图1)。
处理速度(吞吐量)要达到量产时所需要的125枚/小时,需要将曝光装置入光口(中间聚光点)的EUV光输出功率提高至250W。
而目前的输出功率只有10~20W,与目标值存在一位数的差距。
虽然也有报告称瞬间输出功率可以达到100W,但连续发光时间(爆发时间)较短,曝光所需要的平均输出功率只有10~20W的水平(图2)。
图1最大课题是提高EUV光源的输出功率
EUV曝光技术的最大课题是提高光源的输出功率。
量产需要输出功率达到250W,而目前的数值比其低一位数。
(照片由阿斯麦提供,该图由本杂志根据各种发布资料绘制)(点击放大)
图2EUV光的输出功率的思路示意图
就算连续发光时间(爆发时间)仅为1ms时爆发输出功率可达到100W,如果占空比为10%,平均输出功率也只有10W(a)。
量产时需要将爆发时间延长至相当于一次扫描时间的约400ms以上(b)。
(该图由本杂志根据西盟的资料绘制)(点击放大)
EUV光的输出功率在过去5年内几乎没有增加。
这是因为在提高EUV光的输出功率之前,厂商为使光源稳定工作而耗尽了精力。
比如,阿斯麦(ASML)公司2010~2011年共出货了6台用来试制元件的EUV曝光装置“NXE:
3100”注1)。
但是,因EUV光源无法稳定工作,半导体厂商及研究机构无法按计划实施曝光实验。
注1)估计供货对象为英特尔、三星、台积电、东芝、韩国SK海力士及比利时IMEC。
EUV光源难以稳定工作的原因很多,比如,长时间使其产生EUV光的话,光源内就会蓄积庞大的热量,导致各种参数出现偏差。
EUV光的输出功率越高,这种问题就越严重。
因此,EUV光源厂商最近几年一直在大力开发能够使其稳定工作的技术。
这样一来,尽管EUV光源的输出功率基本与原来持平,但使其稳定工作的技术取得了切实进步。
目前,“每天可使100枚以上的晶圆稳定曝光”(美国EUV光源厂商西盟)。
以每天工作20小时计算,吞吐量相当于5枚/小时。
虽然还远远达不到量产所需要的125枚/小时,但“光源不工作,曝光实验无法按计划进行”的情况正在改变。
如果曝光实验取得进展,光刻胶及掩模等的技术开发就会进步。
害怕“单独失败”的阿斯麦
研发EUV曝光技术的企业打算在最近1~2年内大步加快技术开发。
其原因是,如果EUV曝光技术的开发再拖延下去,就相当于自掘坟墓。
导入技术的时间越晚,分辨率及吞吐量等EUV曝光技术所要求的门槛就会越高。
在此期间,利用液浸ArF曝光技术的四重(Quad)图形技术及电子束(EB)曝光技术等竞争技术的开发向前推进,并取代EUV曝光技术的可能性就会提高。
因此,有意见称,“如果2014~2016年不启动EUV曝光技术,就会失去大显身手的机会”(Gigaphoton公司EUV开发部部长助理冈崎信次)。
竭尽全力开发这种技术的是从事EUV曝光装置业务的阿斯麦。
该公司长期开发EUV曝光装置并投入了大量资金。
继元件试制用装置之后,该公司还打算2013年提供11台,2014年提供4台量产用EUV曝光装置“NXE:
3300B”。
好像也有一家半导体厂商订购多台装置的情况。
目前阿斯麦正在制造或测试7台NXE:
3300B(图3)。
如果EUV曝光技术不成功,即便是世界第一大半导体制造装置厂商阿斯麦,根基也有可能发生倾斜。
另外,其他曝光装置厂商实际上已停止开发EUV曝光技术,因此,如果EUV曝光技术无法启动,就会变成阿斯麦的“单独失败”。
图3打算启动EUV曝光技术的阿斯麦
阿斯麦计划2013年出货11台量产用EUV曝光装置,目前已有7台正在制造或者测试。
(该图由本杂志根据阿斯麦的资料绘制)(点击放大)
另一方面,主要EUV光源厂商因巨额开发资金带来负担,没有多余精力加快开发速度。
于是阿斯麦2012年10月决定收购全球最大的半导体曝光用光源厂商西盟。
大多数观点认为,“阿斯麦挽救了苦于EUV光源开发的西盟”(半导体业内人士),也有人指出,英特尔决定向阿斯麦出资的意向起到了助推作用。
阿斯麦打算通过收购西盟,加速开发最大的课题——EUV光源,无论如何也要启动EUV曝光技术。
目标是2015年使EUV光的输出功率达到250W
目前,EUV光源的开发正以两种方式进行。
分别为通过向锡(Sn)液滴照射高输出功率的CO2激光使其产生EUV光的LPP(激光等离子体,laser-producedplasma)方式,以及通过在溶融锡附着的旋转电极之间引发放电现象来产生EUV光的LDP(激光辅助放电等离子体,laser-assisteddischargeplasma)方式。
这些方式的原理都是使锡处于高能量等离子体状态,使用聚光镜将由此放射出来的EUV光聚集在一起(图4)。
图4通过两种方式开发EUV光源
LPP方式通过向锡液滴照射CO2激光来产生EUV光。
而LDP方式通过锡附着的旋转电极之间的放电来产生EUV光。
目前,还看不出哪种方式更适合产生EUV光源,两种方式的开发都在进行。
(该图由本杂志根据阿斯麦的资料绘制)(点击放大)
阿斯麦决定收购的西盟采用LPP方式,迄今为止该公司一直走在实用化的最前列。
这样说的原因是,该公司目前已经出货了5台元件试制用EUV曝光装置使用的光源“HVMI”,并一直在客户那里长期使用。
虽然目前HVMI的输出功率仅为9~13W,但曝光量(DOSE量)的不均减小到了±0.5%以内,西盟一直致力于使光源稳定工作的技术开发注2)。
为了提高输出功率,该公司打算今后分阶段提高CO2激光的输出功率,同时还会改善转换为EUV光的效率,2015年使输出功率达到量产所要求的250W(图5)。
图52015年将提高至250W
西盟计划通过提高CO2激光的输出功率及改善转换效率,2015年使EUV光源输出功率提高至250W。
(该图由本杂志根据西盟的资料绘制)(点击放大)
注2)EUV光源存在的问题是名为“碎片”(Debris)的高能量锡粒子等与聚光镜撞击并附着在上面,导致反射率逐渐降低。
西盟公司采用了名为“氢气Curtain”的方式,通过向光源装置内通入大量氢气,使锡粒子与氢分子碰撞,从而减少与集光镜的撞击,延长聚光镜的寿命。
除了这种方式之外,最近该公司还宣布,通过利用可保护聚光镜表面的封顶层,将聚光镜的寿命延长到了4个月(450亿个脉冲)。
据该公司介绍,最终的目标是使其寿命延长至1年(1000亿个脉冲)以上。
西盟为了提高转换成EUV光的效率,采用了名为“预脉冲(Prepulse)”的技术。
锡液滴的直径约为30μm,而CO2激光的聚光点直径约为100μm。
因此,只有部分CO2激光照射到锡液滴上,转换效率降低。
于是,该公司利用名为预脉冲的弱CO2激光击碎锡液滴,使其扩散为直径100μm左右之后再照射标准的CO2激光。
据西盟介绍,通过这种方法,可将目前1%左右的转换效率提高至2~3%以上。
目前,西盟已成功使用预脉冲技术和15kW的CO2激光,使爆发输出功率为50W、占空比为40%、平均输出功率为20W的EUV光源连续工作5.5小时。
量产用EUV曝光装置使用的光源“HVMII”就采用了这种预脉冲技术。
首台HVMII已经出货,“目前正与阿斯麦的量产用EUV曝光装置进行整合评估”(西盟EUV战略营销副总裁NigelFarrar)。
(记者:
大下淳一,木村雅秀,日经BP半导体调查)
【名词解释】EUV
2013/03/13
EUV是指波长为13.5nm的远紫外光(ExtremeUltra-Violet)。
也称为软X线。
利用远紫外光的EUV曝光技术作为可使半导体进一步微细化的新一代曝光技术而备受期待。
以前的半导体曝光技术是通过缩短所用光线的波长来提高曝光时的分辨率,从而满足微细化需求。
不过,近10年来,曝光波长一直维持在193nm没有改变。
其原因是,业界导入了在镜头与晶圆间充满水的液浸曝光技术,以及反复曝光的二次图形曝光技术等,替代了缩短波长的方法来提高分辨率。
大幅缩短曝光波长
EUV曝光将曝光波长缩短至13.5nm,由此提高曝光时的分辨率。
(本图由《日经电子》根据InternationalTechnologyRoadmapforSemiconductors(ITRS)的资料制作,照片由阿斯麦提供。
)
然而,这些技术也越来越接近极限。
最新的液浸曝光技术的分辨率为38nm左右,即使使用二次图形曝光技术,19nm已是极限。
继续提高分辨率的话,就需要将曝光次数增加到3次以上,这会使成本升高。
而使用波长仅为13.5nm的EUV曝光技术时,一次曝光便可轻松形成14nm左右的图形。
不过,目前EUV曝光技术的开发变得越来越慢。
其主要原因在于,EUV光源的输出功率目前仅为10~20W,还远远达不到量产所需要的250W。
这样下去的话,会给半导体的微细化发展速度造成巨大影响。
因此,从事EUV曝光装置业务的阿斯麦公司(ASML)于2012年10月宣布收购全球最大的EUV光源厂商西盟(Cymer),以加快开发速度。
阿斯麦的目标是2015年使EUV光源的输出功率达到量产所需要的250W。
(记者:
木村雅秀,《日经电子》)
- 配套讲稿:
如PPT文件的首页显示word图标,表示该PPT已包含配套word讲稿。双击word图标可打开word文档。
- 特殊限制:
部分文档作品中含有的国旗、国徽等图片,仅作为作品整体效果示例展示,禁止商用。设计者仅对作品中独创性部分享有著作权。
- 关 键 词:
- EUV 曝光技术 曝光 技术
 冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。
冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。


 1212中级汽车维修工考试试题三.docx
1212中级汽车维修工考试试题三.docx
