 PCB制造工艺流程.docx
PCB制造工艺流程.docx
- 文档编号:24070850
- 上传时间:2023-05-24
- 格式:DOCX
- 页数:11
- 大小:169.26KB
PCB制造工艺流程.docx
《PCB制造工艺流程.docx》由会员分享,可在线阅读,更多相关《PCB制造工艺流程.docx(11页珍藏版)》请在冰豆网上搜索。
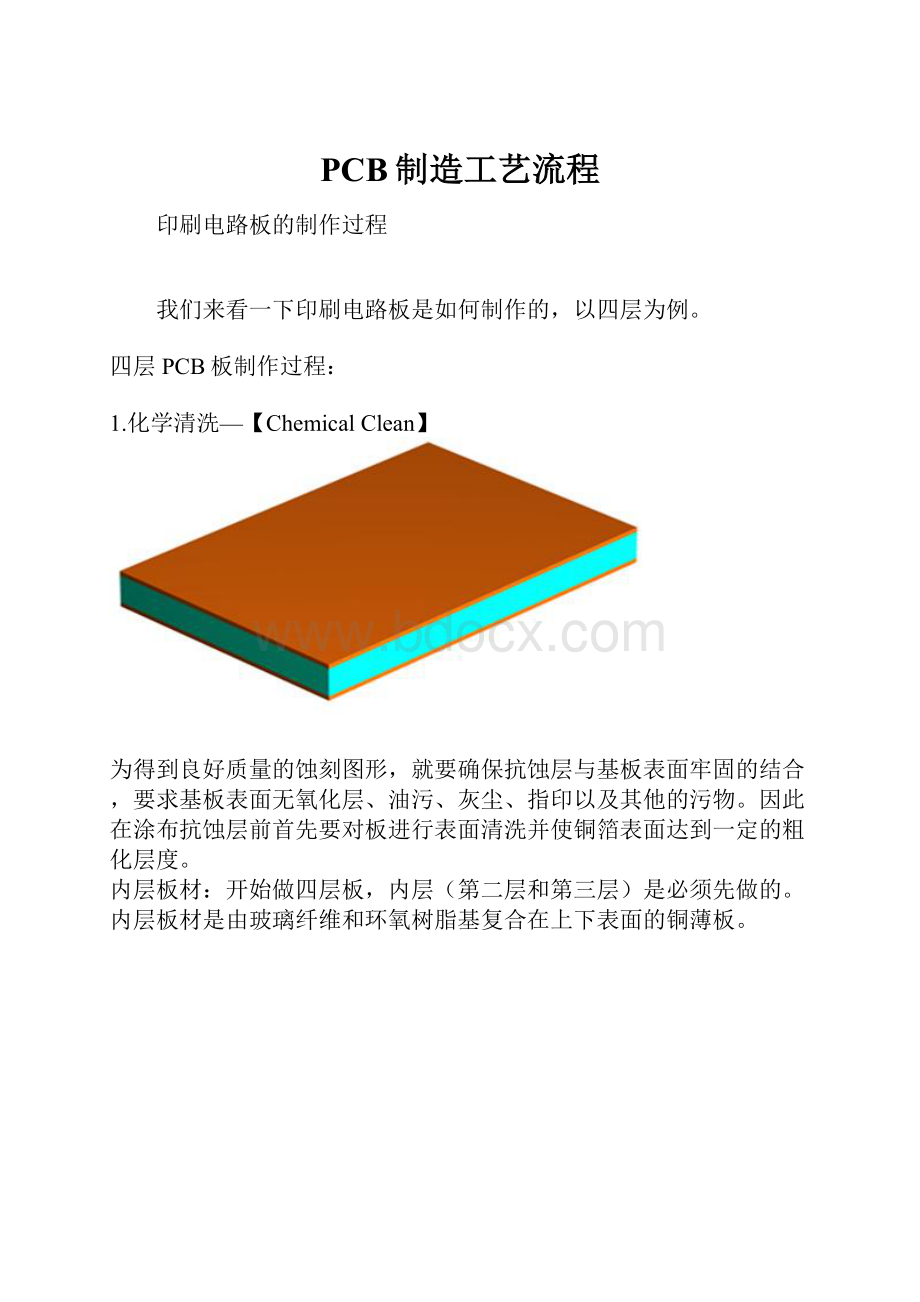
PCB制造工艺流程
印刷电路板的制作过程
我们来看一下印刷电路板是如何制作的,以四层为例。
四层PCB板制作过程:
1.化学清洗—【ChemicalClean】
为得到良好质量的蚀刻图形,就要确保抗蚀层与基板表面牢固的结合,要求基板表面无氧化层、油污、灰尘、指印以及其他的污物。
因此在涂布抗蚀层前首先要对板进行表面清洗并使铜箔表面达到一定的粗化层度。
内层板材:
开始做四层板,内层(第二层和第三层)是必须先做的。
内层板材是由玻璃纤维和环氧树脂基复合在上下表面的铜薄板。
2.裁板压膜—【CutSheetDryFilmLamination】
涂光刻胶:
为了在内层板材作出我们需要的形状,我们首先在内层板材上贴上干膜(光刻胶,光致抗蚀剂)。
干膜是由聚酯簿膜,光致抗蚀膜及聚乙烯保护膜三部分组成的。
贴膜时,先从干膜上剥下聚乙烯保护膜,然后在加热加压的条件下将干膜粘贴在铜面上。
3.曝光和显影-【ImageExpose】【ImageDevelop】
曝光:
在紫外光的照射下,光引发剂吸收了光能分解成游离基,游离基再引发光聚合单体产生聚合交联反应,反应后形成不溶于稀碱溶液的高分子结构。
聚合反应还要持续一段时间,为保证工艺的稳定性,曝光后不要立即撕去聚酯膜,应停留15分钟以上,以时聚合反应继续进行,显影前撕去聚酯膜。
显影:
感光膜中未曝光部分的活性基团与稀碱溶液反应生产可溶性物质而溶解下来,留下已感光交联固化的图形部分。
4.蚀刻-【CopperEtch】
在挠性印制板或印制板的生产过程中,以化学反应方法将不要部分的铜箔予以去除,使之形成所需的回路图形,光刻胶下方的铜是被保留下来不受蚀刻的影响的。
5.去膜,蚀后冲孔,AOI检查,氧化
StripResist】【PostEtchPunch】【AOIInspection】【Oxide】
去膜的目的是清除蚀刻后板面留存的抗蚀层使下面的铜箔暴露出来。
“膜渣”过滤以及废液回收则须妥善处理。
如果去膜后的水洗能完全清洗干净,则可以考虑不做酸洗。
板面清洗后最后要完全干燥,避免水份残留。
6.叠板-保护膜胶片【Layupwithprepreg】
进压合机之前,需将各多层板使用原料准备好,以便叠板(Lay-up)作业.除已氧化处理之内层外,尚需保护膜胶片(Prepreg)-环氧树脂浸渍玻璃纤维。
叠片的作用是按一定的次序将覆有保护膜的板子叠放以来并置于二层钢板之间。
7.叠板-铜箔和真空层压
【Layupwithcopperfoil】【VacuumLaminationPress】
铜箔-给目前的内层板材再在两侧都覆盖一层铜箔,然后进行多层加压(在固定的时间内需要测量温度和压力的挤压)完成后冷却到室温,剩下的就是一个多层合在一起的板材了。
8.CNC钻孔【CNCDrill】
在内层精确的条件下,数控钻孔根据模式钻孔。
钻孔精度要求很高,以确保孔是在正确位置。
9.电镀-通孔【ElectrolessCopper】
为了使通孔能在各层之间导通(使孔壁上之非导体部份之树脂及玻纤束进行金属化),在孔中必须填充铜。
第一步是在孔中镀薄薄一层铜,这个过程完全是化学反应。
最终镀的铜厚为50英寸的百万分之一。
10.裁板压膜【CutSheet】【DryFilmLamination】
涂光刻胶:
我们有一次在外层涂光刻胶。
11.曝光和显影-【ImageExpose】【ImageDevelop】
外层曝光和显影
12.线路电镀:
【CopperPatternElectroPlating】
此次也成为二次镀铜,主要目的是加厚线路铜和通孔铜厚。
13.电镀锡【TinPatternElectroPlating】
其主要目的是蚀刻阻剂,保护其所覆盖的铜导体不会在碱性蚀铜时受到攻击(保护所有铜线路和通孔内部)。
14.去膜【StripResist】
我们已经知道了目的,只需要用化学方法,表面的铜被暴露出来。
15.蚀刻【CopperEtch】
我们知道了蚀刻的目的,镀锡部分保护了下面的铜箔。
16.预硬化曝光显影上阻焊
【LPIcoatingside1】【TackDry】【LPIcoatingside2】【TackDry】
【ImageExpose】【ImageDevelop】【ThermalCureSoldermask】
阻焊层,是为了把焊盘露出来用的,也就是通常说的绿油层,实际上就是在绿油层上挖孔,把焊盘等不需要绿油盖住的地方露出来。
适当清洗可以得到合适的表面特征。
17.表面处理
【Surfacefinish】
>HASL,Silver,OSP,ENIG热风整平,沉银,有机保焊剂,化学镍金
>TabGoldifany金手指
热风整平焊料涂覆HAL(俗称喷锡)过程是先把印制板上浸上助焊剂,随后在熔融焊料里浸涂,然后从两片风刀之间通过,用风刀中的热压缩空气把印制板上的多余焊料吹掉,同时排除金属孔内的多余焊料,从而得到一个光亮、平整、均匀的焊料涂层。
金手指(GoldFinger,或称EdgeConnector)设计的目的,在于藉由connector连接器的插接作为板对外连络的出口,因此须要金手指制程.之所以选择金是因为它优越的导电度及抗氧化性.但因为金的成本极高所以只应用于金手指,局部镀或化学金
最后总结一下所有的过程:
1)InnerLayer内层
>ChemicalClean化学清洗
>CutSheetDryFilmLamination裁板压膜
>ImageExpose曝光
>ImageDevelop显影
>CopperEtch蚀铜
>StripResist去膜
>PostEtchPunch蚀后冲孔
>AOIInspectionAOI检查
>Oxide氧化
>Layup叠板
>VacuumLaminationPress压合
2)CNCDrilling钻孔
>CNCDrilling钻孔
3)OuterLayer外层
>Deburr去毛刺
>Etchback-Desmear除胶渣
>ElectrolessCopper电镀-通孔
>CutSheetDryFilmLamination裁板压膜
>ImageExpose曝光
>ImageDevelop显影
4)Plating电镀
>ImageDevelop显影
>CopperPatternElectroPlating二次镀铜
>TinPatternElectroPlating镀锡
>StripResist去膜
>CopperEtch蚀铜
>StripTin剥锡
5)SolderMask阻焊
>Surfaceprep前处理
>LPIcoatingside1印刷
>TackDry预硬化
>LPIcoatingside2印刷
>TackDry预硬化
>ImageExpose曝光
>ImageDevelop显影
>ThermalCureSoldermask印阻焊
6)Surfacefinish表面处理
>HASL,Silver,OSP,ENIG热风整平,沉银,有机保焊剂,化学镍金
>TabGoldifany金手指
>Legend图例
7)Profile成型
>NCRoutingorpunch
8)ETTesting,continuityandisolation
9)QCInspection
> Ionics离子残余量测试
>100%VisualInspection目检
>AuditSampleMechanicalInspection
>Pack&Shipping包装及出货
说明图为Circuitronic美国总部做的,比较好看,拿过来用了。
- 配套讲稿:
如PPT文件的首页显示word图标,表示该PPT已包含配套word讲稿。双击word图标可打开word文档。
- 特殊限制:
部分文档作品中含有的国旗、国徽等图片,仅作为作品整体效果示例展示,禁止商用。设计者仅对作品中独创性部分享有著作权。
- 关 键 词:
- PCB 制造 工艺流程
 冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。
冰豆网所有资源均是用户自行上传分享,仅供网友学习交流,未经上传用户书面授权,请勿作他用。


 《当代世界政治与经济》.docx
《当代世界政治与经济》.docx
